미세 공정화에 따른 반도체 정밀화학소재 수요증가
Organic hardmask 공정개발 (삼성전자에서 spin on hardmask 공정으로 불림) 차세대 반도체 제조에 있어서 필수인 organic hardmask 공정 및 재료를 세계 최초로 개발하고 특허 출원. 현재 하이닉스 반도체 및 삼성전자에서 현재 및 미래에 계속 사용해야만 하는 기술로 2003년 개발 착수. 2005년 특허 출원 완료 및 등록 (출원번호 10-2005-0014889, 등록번호 10-0787352)
SOD는 반도체 소자의 STI, IMD, PMD와 같은 셀과 셀 사이 및 층간 절연막으로 사용되는 gap-fil 재료로써, 전기적으로 간섭을 막기위해 필요하다. 절연막에 발생된 미세한 void Gate short를 유발하므로 선적이 미세화 될수록 절연물질의 중요성이 더욱 더 커지고 있다. 따라서, 기존의 CVD방식으로 증착되던 절연 물질이 spin-on Dielectric 방식으로 공정이 변화 되고 있으며, 이에 따른 재료도 coating 방식에 적합한 물질로 연구되고 있다. 네오파템이 심혈을 기울여 개발한 Polysilazane SOD(Spin-on Dielectric)가 반도체 제조 산업의 Gap-Filling Technology 분야에서 선도적 역할을 할 것이다.
Replacement CVD Gap fill Layer by spin coater

반도체 제조공정의 단순화와 저에너지 고효율 등의 생산성 향상 반도체 산업에서 미세패턴 형성을 형성하기 위해 일반적으로 화학증기 증착법(CVD) 공정을 이용하여 다층구조로 제작된다. 본사에서 개발한 spin-on amorphous carbon은 반도체 ArF PR을 이용한 etch 공정에서 Si 패턴의 손상을 방지하기 위하여 사용되고 있는 hard mask 로써, CVD 공정에 의해 형성되는 amorphous carbon 층을 대치 하기 위해 개발되었다. 반도체 공정중 SION 막을 입히는 과정에서 SiON deposition이 400 oC 이상에서 수행됨에 따라 600 oC 의 고온에 견딜 수 있는 물질로 개발됨으로써 고온의 환경을 견딜 수 있는 특성을 가지고 있어 타사의 모방이 불가하며 mass production 이 가능하고 간단한 Spin coater를 이용한 공정을 사용하여 hard mask를 형성할 수 있는 polymer를 개발하였다. Siloxane 화합물을 기본으로 하고 광학적, 열적, 표면 특성이 조절된 하드마스크 막을 제조하기 위해 유기 중합체에 가교제 및 첨가제들을 가함으로써 하드마스크 막과 감광층의 식각비가 향상된 스핀코팅 공정용 하드마스크 막으로써의 특성을 향상시켰다.
Replacement of CVD Hard Mask Layer by spin coater

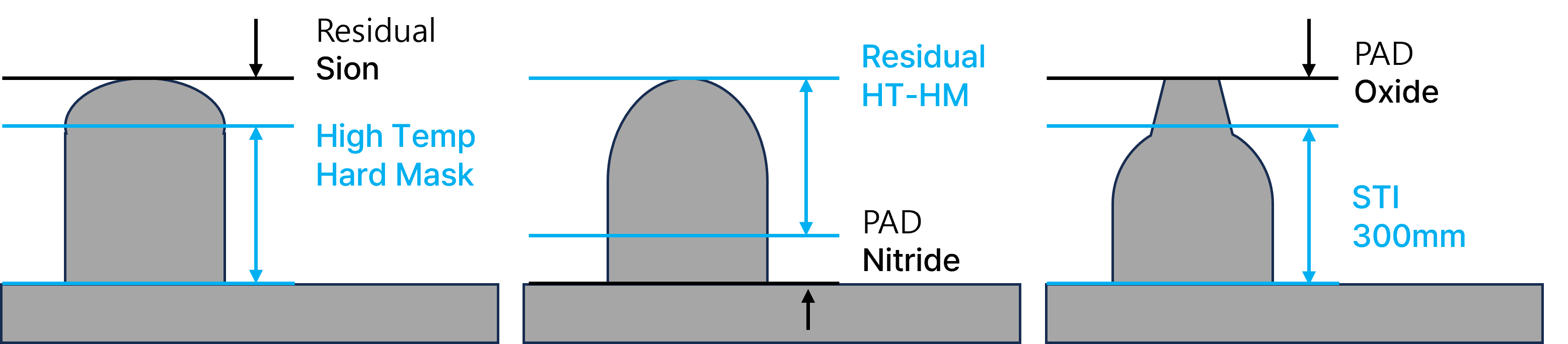
본사에서 개발한 반도체 소자 제조용 고순도 계면활성제 세정액은 패턴이 미세해 짐에 따라 develop 후 rinse 과정에서 DI의 계면장력에 의한 pattern 의 쓰러짐 현상과 이로 인한 partide defect를 개선하기 위한 low surface tension 을 가진 반도체 세정용 surfactant 이다. 일반적으로 70nm이하의 미세패턴 형성시 패턴의 쓰러짐을 막기 위해 포토레지스트 막의 두께를 200nm 이하까지 낮추어야 한다. 이때 사용되는 193nm의 노광 장비에 사용되는 감광제는 지방족 감광제인데, 이는 식각내성이 충분하지 않아 poly, metal, SiO2층 등의 하부층을 식각하고 난후 하부층의 변형으로 반도체 제조가 불가능하다. 또한 패턴이 미세해질수록 균일도가 떨어지면 반도체 소자에 문제가 발생하므로 이를 극복하기 위해 감광제를 두껍게 형성해야만 한다. 그러나 통상적인 현상 공정에서 물을 최종 세정액으로 사용하게 되면 물의 표면장력에 의해 패턴의 쓰러짐이 발생하므로 최종 린스과정에서 계면활성제가 첨가된 세정액으로 처리하는것이 대안이다. 본사의 세정제품은 지방산알칸올 아미드계 계면활성제를 초순수 물에 용해시켜 표면장력을 크게 저하시켜 pattem의 쓰러짐 현상을 막고 탁도(미세 partide)에 의해 defect 가 유발되는 현상 등을 개선하기 위해 가장 중요한 성분이 되는 surfactant는 화학적인 구조를 특이화 함으로써 자체적으로 개발하여 합성 적용하며, 방부제도 자체 개발한 물질을 적용하여 mixing 하여 제조하고 있다. 또한 이들 물질은 Nonylphenol Free 물질로써 친환경 제품으로 인정되고 있다.
Replacement of CVD Hard Mask Layer by spin coater

TAG series (Thermal Acid Generator ; 열산발생제)
반도체 소자 제조 공정에서 포토레지스트는 패턴폭 감소(pattern width slimming) 현상을 개선하기위해 열산발생제를 첨가하여 조성된다. 현상 공정을 거쳐 형성된 패턴을 한번 더 가열하여 열산발생제로 부터 산이 발생되고 이로부터 감광제가 가교 반응을 일으켜, 패턴 형성 후 패턴 폭이 감소하는 현상을 제거하는 효과를 낸다.


p-Toluenesulfonic acid

Trifluoromethanesulfonic acid

Perfluorobutanesulfonic acid
ST-PAG series (Photo Acid Generator; 광산발생제)
반도체 소자의 초고해상도 미세가공을 위해서 고감도의 화학증폭성 포토레지스트를 사용한다. 여기에 주 성분은 산반응성 고분자와 광산발생제로, 유기술폰산 에스터는 원자외선 조사에 의해 광분해 되면서 강산을 발생하고 이는 촉매로서 작용하여 산반응성 고분자와 반응하여 연쇄반응을 개시함으로써 수많은 화학결합을 하거나 분해 반응을 일으킨다. 발생된 산은 노광후 가열단계(post exposure bake:PEB) 과정에서 산반응성 물질에 촉매로써 작용하여 화학반응이 증폭되고 용해도에 큰 차이를 만든다.

Chemical Name: Triphenylsulfonium triflate
Cas no.: 66003-7
- Typical Characteristics:
Appearance: white crystals
Molar mass: 412.45 g/mol
Melting point: 132–134 °C
Imax=233 nm (e=18,000)
e248nm=13,400
Chemical Name: Triphenylsulfonium perfluoro-1-butanesulfonate
Cas no.: 144317-44-2
- Typical Characteristics:
Appearance: white crystals
Molar mass: 562.47 g/mol
Melting point: 82–83 °C
Imax=233.6 nm (e=18,200)
e248nm=13,400
Chemical Name:
Cas no.: –
- Typical Characteristics:
Appearance: white crystals
Molar mass:
? g/mol
Melting point: ? °C
Imax=233 nm (e=?)
e248nm=?